کد QR

درباره ما
محصولات
با ما تماس بگیرید


فکس
+86-579-87223657

پست الکترونیک

نشانی
جاده وانگدا، خیابان زیانگ، شهرستان ووی، شهر جین هوا، استان ژجیانگ، چین
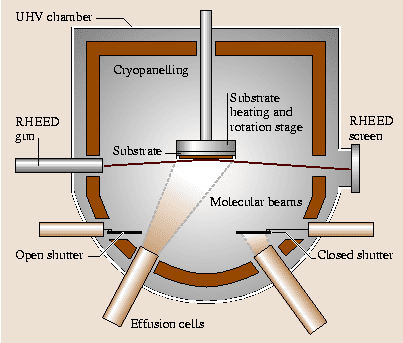
کوره اپیتاکسیال وسیله ای است که برای تولید مواد نیمه هادی استفاده می شود. اصل کار آن این است که مواد نیمه هادی را بر روی یک بستر تحت دمای بالا و فشار بالا قرار دهد.
رشد اپیتاکسیال سیلیکون برای رشد یک لایه از کریستال با یکپارچگی ساختار شبکه خوب بر روی یک بستر کریستالی تک سیلیکون با جهت گیری کریستالی خاص و مقاومت از جهت گیری کریستالی یکسان به عنوان بستر و ضخامت متفاوت است.
● رشد اپیتاکسیال لایه همپایه با مقاومت بالا (کم) روی بستر با مقاومت کم (بالا)
● رشد همبستگی لایه همپایی نوع N (P) روی بستر نوع P (N)
● همراه با فناوری ماسک ، رشد اپیتاکسیال در یک منطقه مشخص انجام می شود
● نوع و غلظت دوپینگ را می توان در صورت نیاز در طول رشد اپیتاکسی تغییر داد
● رشد ترکیبات ناهمگن، چند لایه و چند جزئی با اجزای متغیر و لایههای بسیار نازک
● دستیابی به کنترل ضخامت اندازه در سطح اتمی
● موادی را پرورش دهید که نمیتوان آنها را به کریستالهای منفرد کشید
اجزای گسسته نیمه هادی و فرآیندهای تولید مدار یکپارچه نیاز به فناوری رشد اپیتاکسیال دارند. از آنجا که نیمه هادی ها حاوی ناخالصی های نوع N و P هستند ، از طریق انواع مختلف ترکیبات ، دستگاه های نیمه هادی و مدارهای یکپارچه عملکردهای مختلفی دارند که با استفاده از فناوری رشد اپیتاکسیال می توان به راحتی حاصل شد.
روشهای رشد اپیتاکسیال سیلیکون را می توان به اپیتاکسی فاز بخار ، اپیتاکس فاز مایع و اپیتاکس فاز جامد تقسیم کرد. در حال حاضر ، روش رشد رسوب بخار شیمیایی به طور گسترده ای در سطح بین المللی مورد استفاده قرار می گیرد تا الزامات یکپارچگی کریستال ، تنوع ساختار دستگاه ، دستگاه ساده و کنترل ، تولید دسته ای ، تضمین خلوص و یکنواختی را برآورده سازد.
اپیتاکسی فاز بخار یک لایه تک کریستالی را روی یک ویفر سیلیکونی تک کریستالی دوباره رشد میکند و ارث شبکه اصلی را حفظ میکند. دمای اپیتاکسی فاز بخار کمتر است، عمدتا برای اطمینان از کیفیت رابط. اپیتاکسی فاز بخار نیازی به دوپینگ ندارد. از نظر کیفیت، اپیتاکسی فاز بخار خوب است، اما کند است.
تجهیزات مورد استفاده برای اپیتاکسی فاز بخار شیمیایی معمولاً راکتور رشد همپایه نامیده می شود. به طور کلی از چهار بخش تشکیل شده است: یک سیستم کنترل فاز بخار، یک سیستم کنترل الکترونیکی، یک بدنه راکتور و یک سیستم اگزوز.
با توجه به ساختار محفظه واکنش ، دو نوع سیستم رشد اپیتاکسیال سیلیکون وجود دارد: افقی و عمودی. از نوع افقی به ندرت استفاده می شود ، و نوع عمودی به انواع صفحه مسطح و انواع بشکه تقسیم می شود. در یک کوره اپیتاکسیال عمودی ، پایه به طور مداوم در طول رشد اپیتاکسیال می چرخد ، بنابراین یکنواختی خوب است و حجم تولید بزرگ است.
بدنه راکتور یک پایه گرافیتی با خلوص بالا با نوع بشکه مخروطی چند ضلعی است که به طور خاص در یک زنگ کوارتز با خلوص بالا معلق شده است. ویفرهای سیلیکونی روی پایه قرار می گیرند و با استفاده از لامپ های مادون قرمز سریع و یکنواخت گرم می شوند. محور مرکزی می تواند بچرخد تا یک ساختار کاملاً دوگانه مقاوم در برابر حرارت و ضد انفجار ایجاد کند.
اصل کار تجهیزات به شرح زیر است:
● گاز واکنش از ورودی بنزین در بالای شیشه زنگ وارد محفظه واکنش می شود ، از شش نازل کوارتز که در یک دایره مرتب شده اند ، اسپری می شود ، توسط بافل کوارتز مسدود می شود و به سمت پایین بین پایه و شیشه زنگ حرکت می کند ، واکنش نشان می دهد. در دمای بالا و رسوبات و روی سطح ویفر سیلیکون رشد می کند و گاز دم واکنش در پایین تخلیه می شود.
● توزیع دما 2061 اصل گرمایش: یک جریان با فرکانس بالا و جریان بالا از سیم پیچ القایی می گذرد تا یک میدان مغناطیسی گردابی ایجاد کند. پایه یک هادی است که در یک میدان مغناطیسی گردابی قرار دارد و جریان القایی ایجاد می کند و جریان پایه را گرم می کند.
رشد اپیتاکسیال فاز بخار یک محیط فرآیندی خاص را برای دستیابی به رشد یک لایه نازک از کریستال های مربوط به فاز تک کریستال روی یک کریستال فراهم می کند و مقدمات اساسی را برای عملکردی کردن غرق شدن تک کریستال فراهم می کند. به عنوان یک فرآیند خاص، ساختار کریستالی لایه نازک رشد یافته ادامه بستر تک کریستالی است و یک رابطه متناظر با جهت کریستالی زیرلایه را حفظ می کند.
در توسعه علم و فناوری نیمه هادی ها، اپیتاکسی فاز بخار نقش مهمی ایفا کرده است. این فناوری به طور گسترده در تولید صنعتی دستگاه های نیمه هادی Si و مدارهای مجتمع استفاده شده است.
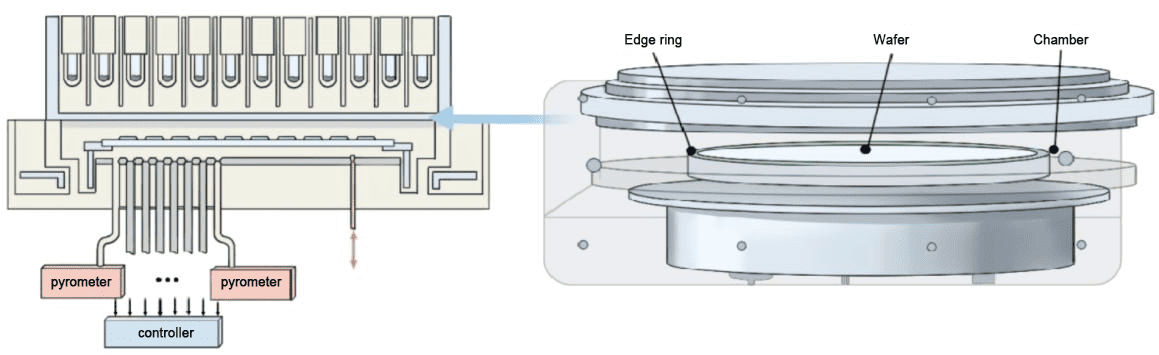
روش رشد اپیتاکسیال فاز گاز
گازهای مورد استفاده در تجهیزات اپیتاکسیال:
● منابع متداول سیلیکونی SiH4، SiH2Cl2، SiHCl3 و SiCL4 هستند. در میان آنها، SiH2Cl2 یک گاز در دمای اتاق، آسان برای استفاده و دارای دمای واکنش پایین است. این یک منبع سیلیکونی است که در سال های اخیر به تدریج گسترش یافته است. SiH4 نیز یک گاز است. ویژگیهای اپیتاکسی سیلان دمای واکنش پایین، بدون گاز خورنده است و میتواند یک لایه اپیتاکسیال با توزیع ناخالصی شدید بدست آورد.
● SIHCL3 و SICL4 مایعات در دمای اتاق هستند. دمای رشد اپیتاکسیال زیاد است ، اما سرعت رشد سریع ، آسان برای تصفیه و استفاده از آن بی خطر است ، بنابراین آنها منابع سیلیکون متداول تر هستند. SICL4 بیشتر در روزهای اولیه مورد استفاده قرار می گرفت و استفاده از SIHCL3 و SIH2CL2 اخیراً به تدریج افزایش یافته است.
● از آنجا که △ ساعت واکنش کاهش هیدروژن منابع سیلیکون مانند SICL4 و واکنش تجزیه حرارتی SIH4 مثبت است ، یعنی افزایش درجه حرارت منجر به رسوب سیلیکون می شود ، راکتور باید گرم شود. روشهای گرمایش عمدتاً شامل گرمایش القایی با فرکانس بالا و گرمایش تابش مادون قرمز است. معمولاً یک پایه ساخته شده از گرافیت با خلوص بالا برای قرار دادن بستر سیلیکون در یک محفظه واکنش کوارتز یا استیل ضد زنگ قرار می گیرد. به منظور اطمینان از کیفیت لایه اپیتاکسیال سیلیکون ، سطح پایه پایه گرافیت با SIC پوشانده شده یا با فیلم سیلیکون پلی کریستالی رسوب می شود.
تولید کنندگان مرتبط:
● بین المللی: شرکت تجهیزات CVD ایالات متحده، شرکت GT ایالات متحده، شرکت Soitec فرانسه، شرکت AS فرانسه، شرکت Proto Flex ایالات متحده، شرکت Kurt J. Lesker از ایالات متحده، شرکت مواد کاربردی از ایالات متحده
● چین: چهل و هشتمین مؤسسه گروه فناوری الکترونیک چین، Qingdao Sairuida، Hefei Kejing Materials Technology Co., Ltd.,معاملات شرکتهای نیمه اندک ، با مسئولیت محدود، پکن جینشنگ میکرونانو ، شرکت فناوری الکترونیکی جینان لیگوان ، آموزشی ویبولیتین.
برنامه اصلی:
سیستم اپیتاکسی فاز مایع عمدتاً برای رشد اپیتاکسی فاز مایع فیلمهای اپیتاکسیال در فرآیند تولید دستگاههای نیمه هادی مرکب استفاده میشود و یک تجهیزات فرآیندی کلیدی در توسعه و تولید دستگاههای نوری است.
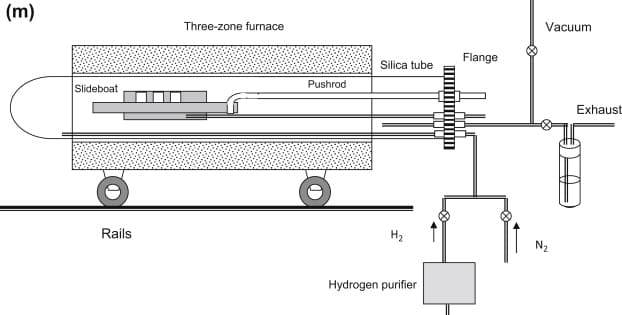
ویژگی های فنی:
● درجه بالایی از اتوماسیون. به جز بارگیری و تخلیه، کل فرآیند به طور خودکار توسط کنترل کامپیوتری صنعتی تکمیل می شود.
● عملیات فرآیند را میتوان با دستکاریکنندگان تکمیل کرد.
● دقت موقعیت یابی حرکت Manipulator کمتر از 0.1 میلی متر است.
● دمای کوره پایدار و قابل تکرار است. دقت منطقه دمای ثابت بهتر از ± 0.5 ℃ است. سرعت خنک کننده را می توان در محدوده 0.1 تا 6 ℃ در دقیقه تنظیم کرد. منطقه دمای ثابت دارای صافی خوب و خطی شیب خوب در طول فرآیند خنکسازی است.
function عملکرد خنک کننده کامل.
function عملکرد حفاظت جامع و قابل اعتماد.
● قابلیت اطمینان تجهیزات بالا و تکرارپذیری خوب فرآیند.
Vetek Semiconductor یک تولید کننده و تامین کننده تجهیزات epitaxial حرفه ای در چین است. محصولات اپیتاکسیال اصلی ما عبارتند ازCVD SIC Barrel Barrel SoSeptor, حساس بشکه روکش شده, SIC SIC Graphite Barrel Barrel برای EPI ، CVD SiC پوشش دهنده ویفر Epi Susceptor, پشتیبانی چرخش گرافیت، و غیره. نیمه هادی Vetek مدتهاست که متعهد به ارائه فناوری پیشرفته و راه حل های محصول برای پردازش اپیتاکسیال نیمه هادی است و از خدمات محصول سفارشی پشتیبانی می کند. ما صمیمانه مشتاقانه منتظر تبدیل شدن به شریک بلند مدت شما در چین هستیم.
اگر سؤالی دارید یا به جزئیات بیشتری احتیاج دارید ، لطفاً در تماس با ما دریغ نکنید.
Mob/WhatsApp: +86-180 6922 0752
ایمیل: anny@veteksemi.com



+86-579-87223657


جاده وانگدا، خیابان زیانگ، شهرستان ووی، شهر جین هوا، استان ژجیانگ، چین
حق چاپ © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. تمامی حقوق محفوظ است.
Links | Sitemap | RSS | XML | سیاست حفظ حریم خصوصی |
